行業(yè)動(dòng)態(tài) 當(dāng)前位置:主頁 > 關(guān)于丹普 > 動(dòng)態(tài)資訊 > 行業(yè)動(dòng)態(tài) >
Ti--Si--N納米復(fù)合薄膜的制備及其力學(xué)性能
發(fā)布時(shí)間:2019-10-30
鈦基涂層如TiN、TiAlN、TiC作為硬質(zhì)耐磨涂層在切削工具領(lǐng)域得到廣泛應(yīng)用,但是隨著加工條件的提高,該類薄膜在抗高溫氧化、硬度、化學(xué)穩(wěn)定性方面表現(xiàn)出了不足。近年來,有研究者在該類薄膜基礎(chǔ)上摻入 Si,制成 TiSiN 納米復(fù)合薄膜,其硬度超過 40 GPa,抗氧化溫度達(dá)900~1000℃ ,因此,有關(guān) TiSiN納米復(fù)合薄膜的研究備受關(guān)注。
用于制備 TiSiN 納米復(fù)合薄膜的方法已有很多,如化學(xué)氣相沉積、磁控濺射、離子束濺射、陰極弧離子鍍等,而物理氣相沉積溫度較低(300~400 ℃),且避免了危險(xiǎn)氣體的使用,更便于工業(yè)化應(yīng)用。其中陰極弧離子鍍產(chǎn)生的等離子體具有離化率、離子能量高的特點(diǎn),更有利于提高涂層的致密性和結(jié)合力。針對硅靶導(dǎo)電性、熱脹性差,不易作為陰極弧靶,BENDAVID 等小組做了多種嘗試,首先是采用 Ti/Si 合金靶 ,但是其固定比例降低了薄膜成分可控性;隨后將陰極弧與 CVD 相結(jié)合,通入硅烷氣體提供硅源 ,Ti 陰極弧提供 Ti 離子。同時(shí),BENDAVID 等和 KIM 等都采用了磁控濺射硅靶與Ti 陰極弧相結(jié)合的方法。這兩種方法都制備出了成分可控的超硬納米復(fù)合膜,并且研究了參數(shù)對薄膜成分、微觀結(jié)構(gòu)以及硬度的影響。最近有一種新技術(shù)是將離子束濺射與帶有 90°磁過濾彎管的陰極弧相結(jié)合來制備 TiSiN薄膜。由磁過濾Ti陰極弧提供Ti離子,離子束濺射αSi3N4 靶,提供Si源。其中陰極弧的90°磁過濾彎管可以過濾掉陰極弧產(chǎn)生的微米級大顆粒,使薄膜更平滑致密。Si以Si3N4 的形式摻入,避免了Si的氮化不充分性。
本文作者采用這種離子束濺射與磁過濾陰極弧共沉積法制備 TiSiN 納米復(fù)合薄膜,并研究沉積參數(shù)對薄膜成分、結(jié)構(gòu),以及硬度、模量、摩擦磨損等力學(xué)性能的影響。
1、實(shí)驗(yàn)
1.1 薄膜制備
以(400)面單晶硅片(厚度550μm)作為基底材料,依次用無水乙醇、丙酮、去離子水超聲清洗20min,經(jīng)高純氮?dú)獯蹈珊蠓湃胝婵帐覂?nèi)。實(shí)驗(yàn)采用自行設(shè)計(jì)的FDJ600高真空多功能薄膜沉積設(shè)備(如圖1所示),本底真空為5.0×10 −4 Pa。首先,用ICP(射頻耦合離子源)產(chǎn)生的氬離子(離子能量為 400 eV)轟擊清洗基底表面20min,然后,用氬離子束濺射Ti靶,沉積10nm 左右的 Ti 過渡層,之后,氬離子束濺射沉積 Si3N4 與磁過濾陰極弧沉積TiN同時(shí)進(jìn)行,制備TiSiN納米復(fù)合薄膜。其中四工位離子束濺射靶配有 αSi3N4 和 Ti 靶(純度99.99%),濺射離子槍束流分別控制在50、70 和135 mA;磁過濾陰極靶材為Ti靶(純度99.96%),反應(yīng)氣體采用氮、氬混合氣(純度均為99.999%),磁過濾線圈電流分別控制在5.0、4.0、3.5、3.0和2.6 A。通過改變離子束濺射的束流和磁過濾線圈電流制備出一系列不同 Si 含量的納米復(fù)合薄膜。工作氣壓為 1.0×10 −1 Pa,溫度小于150℃,所有薄膜厚度均控制在 200 nm 左右。純 TiN 薄膜單獨(dú)由磁過濾陰極弧在同樣條件下制備。
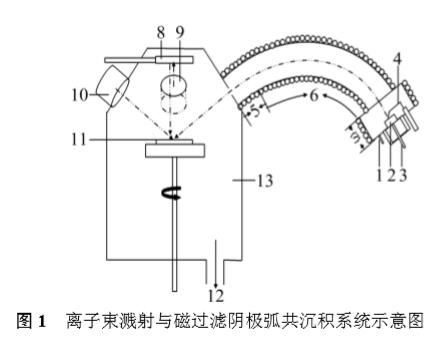
1.2 結(jié)構(gòu)表征
采用Kratos Analytical公司Xis Ultra型X射線光電子能譜(XPS) 對薄膜中元素價(jià)態(tài)進(jìn)行分析,薄膜的組織結(jié)構(gòu)利用荷蘭 Philips公司的X' Pert Pro MPD型 Cu Kα 激發(fā)的X射線衍射儀(XRD),以θ~2θ模式對薄膜的晶體結(jié)構(gòu)進(jìn)行表征。采用日本精工(SII)生產(chǎn)的 SPA400原子力顯微鏡觀察薄膜的微觀形貌。利用日本電子株式會(huì)社(JEOLLtd)的 JSM5600LV 型掃描電子顯微鏡附帶的電子散射譜(EDS)對薄膜的成分進(jìn)行分析。
1.3 力學(xué)性能表征
用哈爾濱刀具廠 2206−B 型表面輪廓儀測量薄膜的厚度。利用美國 CETR 的 UMT−2 多功能摩擦儀考察薄膜在空氣環(huán)境下的摩擦學(xué)性能。摩擦方式為球− 盤往復(fù)摩擦,摩擦對偶為直徑4mm的Si3N4 球,硬度 18 GPa,單次行程為4 mm,濕度50%;摩擦因數(shù)測試條件:載荷0.1N,轉(zhuǎn)速30r/min;磨損率測試條件:載荷0.1N,轉(zhuǎn)速60r/min,時(shí)間10min。薄膜的硬度和彈性模量測試采用安捷倫公司帶有 CSM(連續(xù)剛度,Countinuous stiffness measurement)功能的 Nano Indenter G200型納米壓痕儀,通過測量薄膜硬度和模量對壓入深度的變化,檢測薄膜的硬度和模量結(jié)果。
2、結(jié)果與討論
2.1 X射線衍射(XRD)分析
表 1 所列為 6 個(gè)樣品(S1~S6)的 EDS 分析結(jié)果。由表1可知,薄膜中N含量(摩爾分?jǐn)?shù))保持基本不變,隨著Si含量的增大,Ti含量逐漸下降。通過改變離子束濺射的束流和磁過濾線圈電流使薄膜中 Si 含量具有較強(qiáng)的可控性,所制備的 TiSiN 薄膜中 Si 含量在 3.2%~15.5%的范圍。

圖 2 所示為不同薄膜的 XRD 譜。從圖 2 可以看出,純 TiN 薄膜為面心立方(FCC)結(jié)構(gòu),具有(200)面擇優(yōu)取向。TiSiN 薄膜中晶相同樣具有(200)面擇優(yōu)取向的 FCC 結(jié)構(gòu),且(200)峰明顯寬化。根據(jù) TiN 薄膜的研究結(jié)果,當(dāng)薄膜中不存在或存在較小的殘余應(yīng)力時(shí),以表面能最小的(200)面擇優(yōu)取向 。由此可見,樣品S1~S6中的殘余應(yīng)力均較小。圖2中未出現(xiàn)晶相 Si3N4 和鈦硅化物的衍射峰,Si 除了可能以非晶態(tài) Si3N4 形式存在之外,由于物理氣相沉積的過程往往被認(rèn)為是極不平衡的過程,所以還有可能以 Ti(Si)N 固溶體的形式存在,當(dāng)固溶體中的Si達(dá)到飽和之后才能形成非晶態(tài) Si3N4。當(dāng) TiN 中部分 Ti 元素被 Si 元素取代后,由于Si的半徑小于Ti,必然會(huì)導(dǎo)致其晶格常數(shù)的降低。圖 2 中樣品 S1~S3 隨著 Si 含量的增加,(200)晶面逐漸向高角移動(dòng),之后穩(wěn)定在 42.6°。由此可見,樣品 S1~S3 薄膜中晶相是以 Ti(Si)N 固溶體的形式存在,當(dāng)固溶體中 Si 飽和后,又有非晶態(tài) Si3N4 相出現(xiàn)。根據(jù)(200)晶面衍射峰的半高寬,利用謝樂公式計(jì)算了薄膜中的晶粒尺寸,如圖 3 所示。 TiSiN 薄膜中的晶粒尺寸在 20~30 nm 之間。隨著 Si 的摻入,晶粒尺寸變化不大,只在Si含量大于10.9% 之后明顯下降。此現(xiàn)象與其他研究結(jié)構(gòu)相似,非晶相 Si3N4 的出現(xiàn),限制了晶粒的進(jìn)一步生長,導(dǎo)致了晶粒粒徑的下降。
2.2 X射線光電子能譜(XPS)分析
從 XRD 結(jié)果分析得到的信息在 XPS 結(jié)果中得到進(jìn)一步的證明。圖4所示為薄膜樣品S4中的Si 2p XPS 譜。經(jīng)過擬合分峰,從圖 4 可以看出,樣品 S4(Si 含量 10.9%)中的 Si 2p 峰由兩個(gè)峰合成,1 號(hào)峰位于101.7 eV附近,與Si3N4 中的Si 2p峰位一致,2號(hào)峰位于102.6eV附近,應(yīng)該對應(yīng)于Ti(Si)N固溶體中Si 2p的結(jié)合能,由于它既不對應(yīng)于更高鍵能的 SiO2(103.1 eV)中的Si,也不對應(yīng)于較低鍵能的TiSi(98.8 eV)中的 Si,且與所報(bào)道的非平衡狀態(tài)Ti(Si)N固溶體中 Si 2p 峰的峰位相吻合。結(jié)合 XRD 結(jié)果可知,薄膜中晶相是以 Ti(Si)N 固溶體的形式存在,當(dāng)固溶體中 Si 飽和后,又有非晶態(tài) Si3N4 相出現(xiàn)。由此可見,即使利用了磁過濾陰極弧這種離化率和離子能量較高的方法,在不對基底加熱、加負(fù)偏壓的情況下,仍然不利于TiN和Si3N4 的兩相分離。
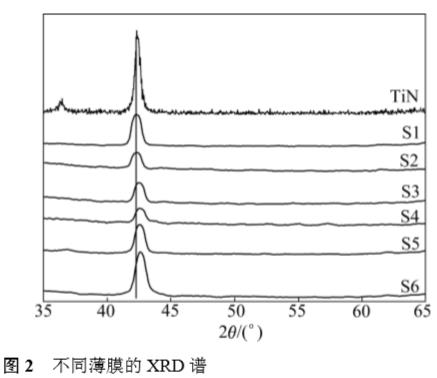


2.3 形貌分析
圖5所示為不同Si含量TiSiN薄膜的三維原子力顯微鏡圖。隨著Si含量的增加,薄膜的表面形貌和粗糙度(見表1)發(fā)生了明顯的改變。根據(jù)XRD和XPS結(jié)果的分析,結(jié)合所得的薄膜微觀結(jié)構(gòu)可知,開始少量的Si溶入TiN晶格形成固溶體,薄膜表面仍是柱狀晶生長形成的晶粒凸起(見圖5a~c),隨著Si含量的進(jìn)一步增大,形成的 Si3N4 非晶相的增加,附著在晶粒表面,阻礙了晶粒的進(jìn)一步增大,同時(shí)填補(bǔ)了表面晶粒凸起間的凹坑,使得薄膜表面變得更加平滑(見圖 5(d)~(f))。這與已有的研究結(jié)果一致。
2.4 薄膜納米硬度和彈性模量測試
采用 CSM 模式測量薄膜硬度與壓入深度之間的關(guān)系。曲線的平臺(tái)區(qū)硬度值即為薄膜的硬度值,每個(gè)樣品取5 個(gè)不同點(diǎn),測試后取平均值。圖 6所示為不同Si含量樣品的納米硬度和彈性模量。從圖6可以看出,薄膜的硬度值均在22~26 GPa之間,隨著Si含量的增加,薄膜硬度隨之增大;Si 含量為 10.9%時(shí),硬度達(dá)到最大值,之后硬度減小。彈性模量也表現(xiàn)出與硬度相似的變化趨勢,在 Si 含量為 10.9%時(shí),彈性模量達(dá)到了最大值。關(guān)于薄膜材料的增硬理論有很多:壓應(yīng)力增強(qiáng),固溶體增強(qiáng),晶粒細(xì)化增強(qiáng),混凝土微觀結(jié)構(gòu)增強(qiáng)等。根據(jù)XRD結(jié)果可知,薄膜中的應(yīng)力較小,晶粒粒徑變化不大,且樣品 S4 的晶粒還比其他樣品稍大,因此排除了應(yīng)力增強(qiáng)和晶粒細(xì)化增強(qiáng)的原因。據(jù)報(bào)道,基于固溶體增強(qiáng)的機(jī)理,TiSiN 薄膜中存在最佳的Si含量導(dǎo)致薄膜出現(xiàn)增強(qiáng)效應(yīng)。在本實(shí)驗(yàn)中薄膜材料同樣存在 Ti(Si)N 固溶體微觀結(jié)構(gòu),基于固溶體增強(qiáng)機(jī)理,最佳Si含量為10.9%。雖然在高 Si 含量的樣品中出現(xiàn)了 Si3N4 非晶相,但是在本實(shí)驗(yàn)范圍內(nèi),薄膜中晶相的晶粒粒徑較大,非晶相的相對較少,未出現(xiàn)混凝土結(jié)構(gòu)增強(qiáng)效應(yīng)。


2.5 摩擦學(xué)性能測試
作為硬質(zhì)涂層使用的 TiSiN 薄膜,其摩擦學(xué)性能對其應(yīng)用是至關(guān)重要的。根據(jù)以往報(bào)到,此類硬質(zhì)薄膜在與金屬對偶對磨的時(shí)候,由于硬質(zhì)薄膜對軟金屬的黏著、切削導(dǎo)致摩擦因數(shù)較高,在0.6~0.9之間。在本研究考察了不同Si含量的TiSiN薄膜在低載荷下與硬度較高的陶瓷對偶的摩擦學(xué)性能。采用了硬度為 18 GPa的Si3N4 球,載荷為0.1N,濕度為50%。摩擦因數(shù)與時(shí)間、摩擦因數(shù)和磨損率與Si含量之間的關(guān)系如圖7 和8 所示。由圖 7可見,所有樣品的摩擦因數(shù)均維持在 0.13~0.17 之間,未出現(xiàn)磨合階段,整個(gè)過程波動(dòng)較小,穩(wěn)定性較好。同時(shí),從圖8還可以看到,隨著薄膜中Si含量逐漸增加,薄膜的摩擦因數(shù)和磨損率逐漸減小,Si 含量為 10.9%時(shí),兩者達(dá)到最佳值;當(dāng)Si 含量大于10.9%后,摩擦因數(shù)和磨損率均有所增大。此現(xiàn)象與所報(bào)道的 Si3N4 對偶與 Si3N4 薄膜以及 TiSiN 薄膜在潮濕環(huán)境中對磨的摩擦行為一致。由于在潮濕環(huán)境中, Si3N4 在摩擦過程中與水反應(yīng)生成了具有減摩作用的硅的氧化物、氫氧化物,大大降低了摩擦因數(shù)。更由于本研究所制備的薄膜表面光滑致密,且載荷較小,致使所有樣品的摩擦因數(shù)均維持在 0.13~0.17 之間,未出現(xiàn)磨合階段。從樣品 S1 到樣品 S4,隨著粗糙度的降低和硬度的增大,導(dǎo)致其摩擦因數(shù)和磨損率隨之下降,而樣品S5和S6的硬度下降,促使其磨損率增大,同時(shí)磨損產(chǎn)生的磨屑會(huì)使摩擦因數(shù)升高。從圖7可以看到,樣品S1、S2、S5和S6薄膜的摩擦曲線有輕微的震蕩,說明磨損產(chǎn)生的磨屑導(dǎo)致其摩擦因數(shù)和磨損率升高。


3、結(jié)論
1) 采用離子束濺射和磁過濾陰極弧等離子體共沉積技術(shù)在單晶硅基底上成功制備了 TiSiN 納米復(fù)合薄膜。
2) XPS、EDS 和 XRD 結(jié)果表明,薄膜由晶態(tài)的 Ti(Si)N 固溶體和非晶態(tài)的 Si3N4 組成,薄膜中的晶相以(200)面擇優(yōu)取向。磁過濾陰極弧這種離化率和離子能量較高的方法,在不對基底加熱、加負(fù)偏壓的情況下,仍然不利于TiN和Si3N4 的兩相分離。
3) 薄膜硬度在22~26 GPa之間,基于固溶體增強(qiáng)效應(yīng),Si 含量(摩爾分?jǐn)?shù))為 10.9%時(shí),薄膜的硬度和彈性模量均達(dá)到最大值。
4) 以 Si3N4 為對偶,薄膜的摩擦因數(shù)均維持在 0.13~0.17之間;在Si含量為10.9%時(shí),薄膜的摩擦因數(shù)和磨損率達(dá)到最低值。
聲明:本站部分圖片、文章來源于網(wǎng)絡(luò),版權(quán)歸原作者所有,如有侵權(quán),請點(diǎn)擊這里聯(lián)系本站刪除。
| 返回列表 | 分享給朋友: |








 京公網(wǎng)安備 11010502053715號(hào)
京公網(wǎng)安備 11010502053715號(hào)